
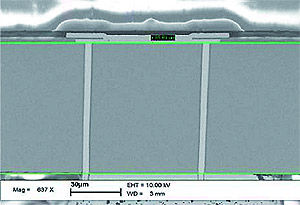
Описанная технология – результат почти десятилетних исследований IBM, и она уже достаточно отработана, чтобы перебраться из лаборатории на конвейер: массовое производство планируется начать в 2008 году. В первую очередь IBM собирается выпускать по новой методике микросхемы усилителей мощности базовых станций беспроводной связи. В планах компании также использовать 3D-технологию для изготовления комплектующих к высокопроизводительным серверным системам и суперкомпьютерам. 3D chip-stacking уже находит применение, например, в суперкомпьютерах Blue Gene, позволяя напрямую соединять друг с другом несколько процессоров, а также процессоры и память (пропускная способность «шины» в подобных сэндвичах просто фантастическая). Двигаясь этим путем, IBM планирует прийти к новому поколению суперкомпьютеров.
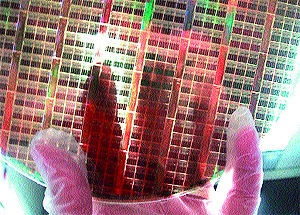
Конечно, столь многообещающее направление развивает отнюдь не только Голубой Гигант. Intel давно работает над аналогичной трехмерной упаковкой процессоров, однако, по словам разработчиков корпорации, объединение нескольких процессоров "по вертикали", несмотря на привлекательность и элегантность подхода, сопряжено со значительными технологическими трудностями – пока намного проще наращивать производительность, располагая чипы в двух измерениях. Samsung и ряд японских компаний (Sony, NEC Electronics, Elpida Memory, Oki Electric) надеются в ближайшие годы приспособить трехмерную компоновку для чипов флэш-памяти и DRAM.
